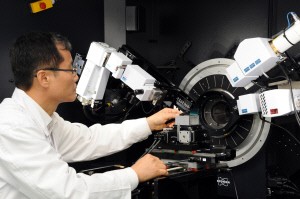
한국표준과학연구원(KRISS)은 재료측정표준센터 김창수 박사팀이 신물질을 활용해 10나노미터(㎚) 이하의 반도체 두께 인증표준물질을 국내에서 처음으로 개발했다고 26일 밝혔다.
이번에 개발한 반도체 두께 인증표준물질은 절연성 높은 유전체인 하이-K 물질 '하프늄 산화막(HfO2)'을 이용해 만들었다. 실리콘 기판위에 실리콘 산화막(SiO2)을 1마이크로 미터 두께로 씌운 뒤 그 위에 수 나노미터 두께의 하프늄 산화막(HfO2)을 원자층 단위 두께로 증착시키는 기술(ALD법)을 활용했다.
이를 통해 초미세 반도체 제조 공정 시 기존의 10 나노미터급 이상의 실리콘 산화막(SiO2) 측정 기준자보다 더 정확한 두께 표준을 제공하고 기존의 방식에서 발생했던 두께 측정 불확도 요소를 완전히 제거했다.
연구를 진행한 김창수 박사는 "반도체 제조 공정에서 박막 두께 제어는 반도체 수율에 직접적 영향을 주는 요인 중 하나"라며 "부정확한 표준물질로 계측기기를 교정할 경우 수백만 개의 반도체 칩을 폐기해야 하는 손실이 발생할 수도 있는데 이번 인증표준물질의 개발로 이러한 위험성을 줄일 수 있게 됐다"고 말했다.
표준연은 이번에 개발한 두께인증표준물질을 반도체, 디스플레이, 나노전자소자 및 나노소재 개발 등 산업체 연구개발 현장에 제공하고 연구소, 학교 등으로 확대 보급할 예정이다. 또 올해 하반기에 세계 표준기간들과의 국제비교를 실시해 그 결과를 측정능력표(CMC table)에 등재할 계획이라고 밝혔다.
jhpark@fnnews.com 박지현 기자
※ 저작권자 ⓒ 파이낸셜뉴스, 무단전재-재배포 금지
















